 |
Akrometrix於1994年成立於美國佐治亞州亞特蘭大, 全球著名的平整度特性測量與分析技術先鋒。 提供全面測量解決方案的領導者,爲全球微電子工業市場提供先進的基板及封裝測量解決方案。TherMoiré 設備系列能提供廣泛的平整度檢測特性技術。是溫度效應測量技術的行業先鋒,全球二十大半導體生產商,都採用了Akrometrix的解決方案。
滿足國際標準: IPC-9641,JESD22-B112A,日本JEITA ED-7306,JEDEC 22B112
|
|
Shadow Moiré 技術 Shadow Moiré 是一種非接觸式,全視野的光學技術,用樣品上的參考光柵和它的影子之間的幾何干擾產生摩爾雲紋分佈圖(Moiré Pattern),進而計算出各像素位置中的相對垂直位移。它需要一個倫奇刻劃光柵(Ronchi-ruled grating),一條大約45度角的光源和一個垂直於光柵的相機。 |
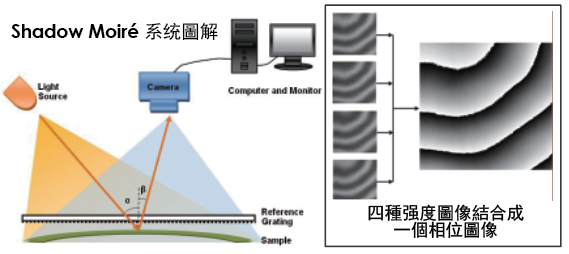 |
|
新一代表面測量和分析技術 Akrometrix的專利TherMoiré技術是行業領先的熱變形翹曲分析技術。自一九九八年以來,TherMoiré產品作爲翹曲管理解決方案,服務於全球企業。TherMoiré技術可以模擬迴流焊製程和操作環境條件、同時捕捉一個完整的歷史翹曲位移表現。運用這重要信息,獲得元器件/基板翹曲度的一致性來直接影響一級和二級裝配產量和提高產品的可靠性。可應用於研發/診斷/生產監控,測試結果符合國際標準 (JEDEC, JEITA等),測試精度爲微米級,極大滿足高端客戶對翹曲測試監控的要求,是國際主流並被JEDEC,JEITA等標準推薦的測試方法,主要參數有 Coplanarity,Sign warpage,Fulfill signed warpage, Twist,Bow,CTE 等。 |
|
TherMoiré AXP3 產品特性• 最大樣品尺寸 : 400 mm x 400 mm 自動化控制 |
針對細小樣品也能測量熱變形 |
AXP |
|
|
印刷電路板
|
插座
|
QFN (3mm x 3mm)
|
|
|
上/下加熱模組 (with Top/Bottom Heating Chamber)
AXP 3 有以下特性:
• 上下兩個加熱區域使得測量物的溫差<±5ºC
• 可以測量不噴漆的樣品
• 來自前後的雙重降溫裝置,及左、右和底部的3倍排氣通道,帶來更快、更均勻的降溫效果
|
AXP3 Unpainted 樣品 |
AXP3 Top/Bottom Heater |
Digital Fringe Projection - DFP 解決方案模組新的獨立產品提供純對流加熱組裝回流模擬方式,能有效測量帶臺階的樣品及保留鍚球的測量 !
|
Digital Image Correlation - DIC CTE模擬模組
|
|
|
|
Akrometrix Studio 軟體 一套先進的集成軟體模組,提供最全面的表面表徵和分析能力運作。當運用TherMoiré AXP3 系統時,Studio可組成一套測量解決方案,產生快速,全面表徵了廣泛的微電子部件和組件的表面信息。Studio使用不同種類的強大圖形和分析功能為用戶得出結論,並作出決定。
|
|
|
PS600S - 大尺寸基板翹曲解決方案
特有的FOWLP技術在平板上“單次捕獲”完成視圖翹曲測量!
• 利用Shadow Moiré 技術進行翹曲測量
• 可進行晶圓與平板大面積的翹曲測量 • 既可用於小面積,亦可用於大面積的翹曲測量 • 測量面積可達600mm x600mm • 採用NIST標準標定 • Z-軸解析度可達1.25µm • 全視野FOV成像,不論晶圓大小都可「單次捕捉」 整個晶圓/平板,捕捉時間少於2秒 • 如需使用26°C~300°C的熱變形測量,配加熱裝置 • 針對小樣品(200mm x 200mm),Akrometrix提供PS200S型號 |
扇出晶圓加工 (FOWLP) - Fan Out Wafer Level Processing |
|
TTSM (Table Top Shadow Moiré) - 桌上型常溫翹曲度量測儀
運行於Akrometrix Studio軟體(與所有Akrometrix系統相同),具有許多軟體功能
|
 |
|
TTSM是一種具有室溫翹曲計量能力的基礎系統。承載傳統的Shadow Moiré技術優勢,非接觸式,檢測速度(2秒以下),大量測面積(310x300mm),可輕鬆配合2個JEDEC置具,具有高精度(+/- 2.5µm至+/- 1.27µm,取決於光柵)。 |
 |
|
| • LED光源 • 高強度均勻性 • 低發熱量 |
• 顯示器/鍵盤/ PC塔 • 在Akrometrix Studio軟體套件上運行 • 與所有Akrometrix系統相同的軟體介面 |
|